2022-06-09
隨著科技的發展,企業對高精度的產品要求及依賴越來越高,小到人們隨處可見可用的手機,平板,音響大到飛行器,高鐵汽車等都離不開芯片。而芯片的制造水平也是反應一個國家綜合實力的縮影。為了防止有缺陷的晶片流入芯片后道封裝工序,高精度的光學檢測設備和檢測手段非常必要。立儀科技研發的3D線共焦,采用國際領先的白光共焦技術,具備亞微米級別超高測量精度,可兼容多種不同材料,從鏡面反射到漫反射、從透明材料到不透明材料均可適用,完美實現半導體封測階段工件3D形貌測量,打破國外量測設備封鎖,實現國產替代。可對物體3D形貌進行全場掃描,實現三維輪廓、平整度、粗糙度、高差、縫寬等檢測和測量。
先進封裝晶圓Bump三維形貌測量
晶圓級先進封裝技術是行業發展的大趨勢,該種類型晶圓表面3D精密測量和檢測對產品質量的控制至關重要。通過高精度測量頭可檢測芯片是否存在設計缺陷或者制造過程導致的物理異常。熵智科技高精度線光譜光學探頭,可用于測量晶圓bump高度、直徑,bump的共面性,識別bump缺陷,例如缺失、偏移、短接等,可達到亞微米級的精密測量要求。

根據實際采集的點云數據,測量焊球高度重復測量誤差±0.001mm
成品芯片BGA焊球三維形貌測量
細間距BGA封裝芯片表面錫球具有非常高的尺寸及外形精度要求,以保證芯片貼裝的精度和連接質量。立儀科技自研的3D線光譜共焦傳感器,可對BGA焊球進行全場3D形貌掃描,實現芯片貼裝表面三維輪廓精確測量,解析BGA焊球共面度、段高差、體積等幾何信息。
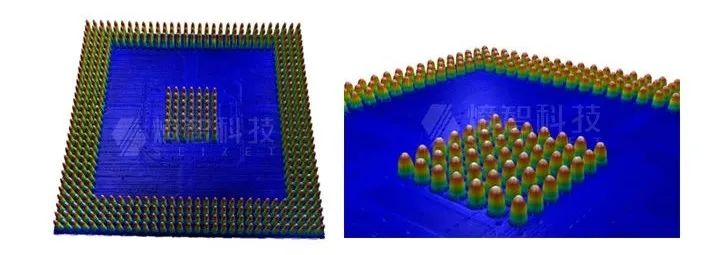
3D線光譜共焦傳感器采集的BGA芯片3D點云圖

截取剖面,兩端的階躍處為起始點和終止點,重復測量誤差±0.005mm
PCB板孔深孔徑三維形貌測量
印刷電子產品制造中高精度PCB板孔深孔徑三維形貌測量是行業難題,立儀科技3D線光譜共焦傳感器經實測可兼容不同基板材料印刷電路板,實現產品表面粗糙度測量,印刷結構臺階高度和寬度測量,深孔形貌測量等,同時傳感器可適應有光澤的、光滑的和透明的材料(如玻璃或聚脂薄膜),實現快速準確的3D形貌成像。
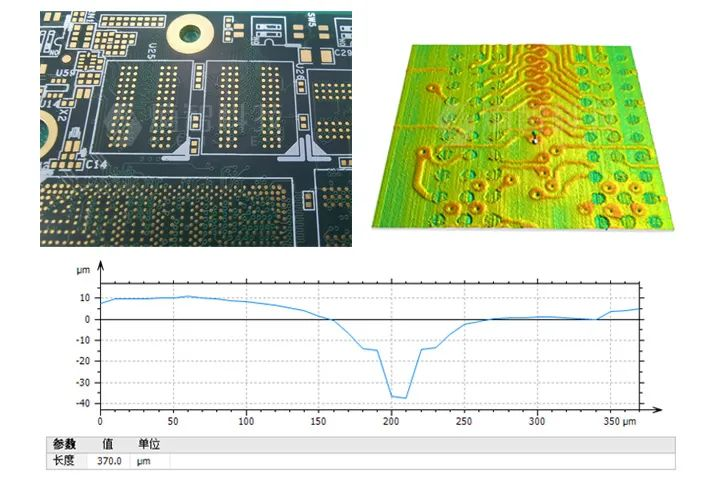
經比對,PCB板孔深重復測量誤差可達±0.002mm,滿足實際測量要求
深圳立儀科技有限公司,成立于2014年,是一家以精密光學檢測為主業的民營高科技企業,專業生產及銷售線光譜共焦位移傳感器,激光位移傳感器,白光干涉儀,膜厚儀,成立近10年的,為數百家企業解決了測量難題。



